|
ГЭТ 203-2024
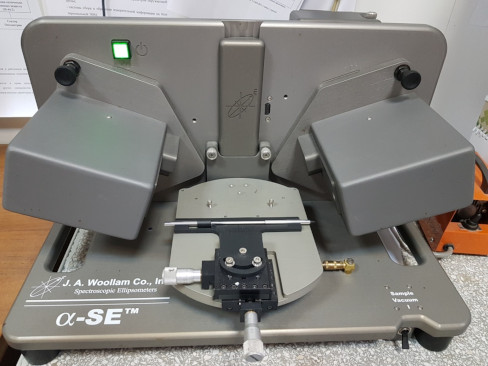
Спектральный эллипсометр α-SE фирмы J.A. Woollam Co
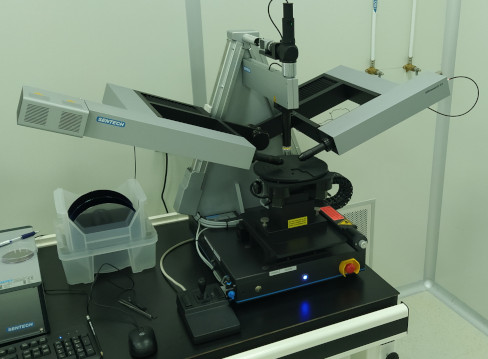
Спектральный эллипсометр SENresearch 4.0 SER 850-FTIR фирмы Sentech
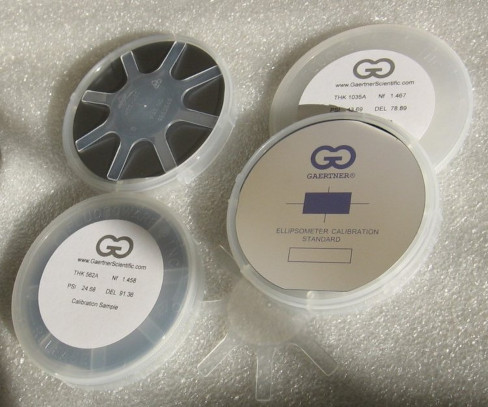
Эталонные меры плоские SiO2/Si, кремний на изоляторе КНИ

Эталонные меры цилиндрические в виде оптических покрытий SiO2
Государственный первичный эталон состоит из комплекса следующих технических средств и вспомогательных устройств:
- цифрового спектрального эллипсометра alpha-SE;
- цифрового спектрального многоуглового эллипсометра SENresearch 4.0, модель SER 850-FTIR;
- мер комплексного показателя преломления и толщины оптических покрытий в виде подложек плоской или цилиндрической формы из различных материалов с однослойными или двухслойными покрытиями разной номинальной толщины из разных материалов, а также массивные заготовки из различных материалов – как материальных носителей единицы комплексного показателя преломления и единицы длины в области измерений толщины оптических покрытий;
- термогигрометра ИВА-6 для измерений температуры, атмосферного давления и влажности воздуха в зоне измерений;
- системы сбора и обработки измерительной информации на базе персональной ЭВМ.
|
Государственный первичный эталон применяют для измерения комплексного показателя преломления N=n-ik и, соответственно, оптических постоянных n и k тонкопленочных структур, представляющих собой комбинации тонких металлических, диэлектрических и полупроводниковых слоев (пленок) на поверхности полупроводникового кристалла или изолятора. Бесконтактные измерения толщины d оптических покрытий в широком диапазоне от нанометров до десятков микрометров на цифровом спектральном многоугловом эллипсометре SENresearch 4.0, обладающем сканирующим Фурье-спектрометром в ИК диапазоне длин волн (FTIR-приставка). Контроль технологических параметров (толщина, композиция состава, величина шероховатости) в полупроводниковой микро- и наноэлектронике, в рентгеновской оптике, оптике интерференционных покрытий, включающих слои диэлектриков, полупроводников и металлов. Комплексный показатель преломления необходимо измерять и учитывать при интерференционных измерениях высоты рельефа и/или толщины в нанометровом диапазоне.
Основные области применения:
- микроэлектроника
- физика твердого тела
- физика поверхности
- материаловедение
- технология оптических покрытий
- химия полимеров и электрохимия
- биология, медицина
Измерение комплексного показателя преломления (его составляющих n и k) и толщины оптических покрытий выполняется с помощью двух спектральных эллипсометров α-SE фирмы J.A. Woollam Co и SENresearch 4.0 SER 850-FTIR фирмы Sentech через измерение эллипсометрических углов. Используются как стандартные модели «Transparent Film», «Absorbing Thin Films (B-Spline)», «Metal Substrates», так и собственные модели в зависимости от типа подложки (кремний, сапфир, ситалл, алюминий). Для передачи размера единиц изготовлены эталонные меры комплексного показателя преломления и толщины оптических покрытий однослойные и многослойные в виде плоских и цилиндрических подложек с пленками различной толщины из разных диэлектриков и полупроводников, а также массивные заготовки из кремния и металлов.

Контактные данные
|